
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Чип өндірісіндегі SiGe: кәсіби жаңалықтар туралы есеп
Жартылай өткізгіш материалдардың эволюциясы
Заманауи жартылай өткізгіштер технологиясы саласында миниатюризацияға деген тынымсыз қозғалыс кремний негізіндегі дәстүрлі материалдардың шегін ығыстырды. Жоғары өнімділік пен төмен қуат тұтыну талаптарын қанағаттандыру үшін SiGe (Silicon Germanium) бірегей физикалық және электрлік қасиеттеріне байланысты жартылай өткізгіш чип өндірісінде таңдаулы композициялық материал ретінде пайда болды. Бұл мақала мынаны қарастырадыэпитаксиялық процессSiGe және оның эпитаксиалды өсудегі рөлі, штамм кремний қолданбалары және Gate-All-Around (GAA) құрылымдары.
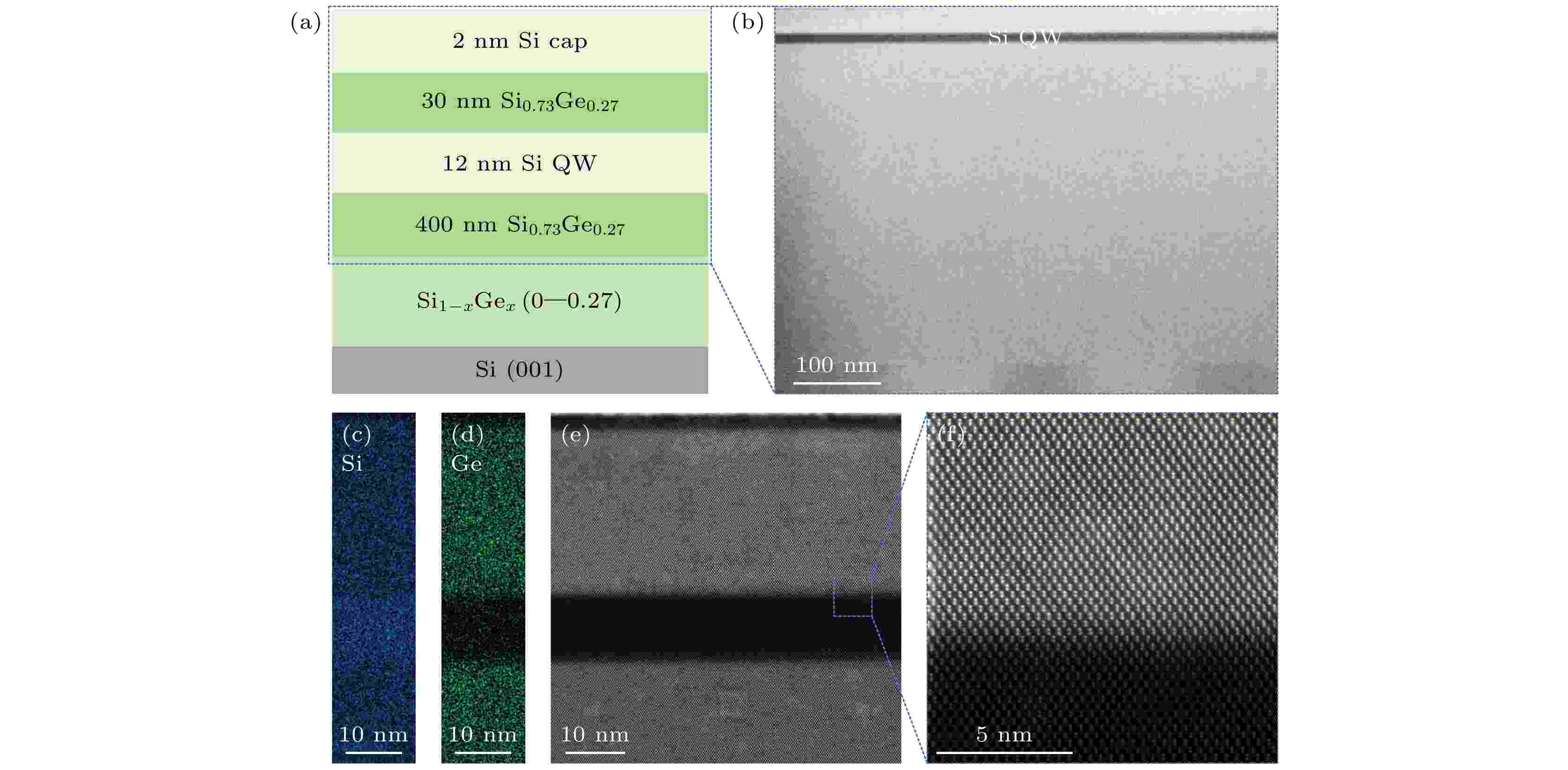
SiGe эпитаксисінің маңызы
1.1 Чип өндірісіндегі эпитаксияға кіріспе:
Көбінесе Epi деп қысқартылған эпитаксия бір кристалды субстратта бір кристалды қабаттың тордың орналасуымен бірдей өсуін білдіреді. Бұл қабаттың екеуі де болуы мүмкінгомоэпитаксиалды (мысалы, Si/Si)немесе гетероэпитаксиалды (мысалы, SiGe/Si немесе SiC/Si). Эпитаксиалды өсу үшін әртүрлі әдістер қолданылады, соның ішінде молекулярлық сәуле эпитаксисі (MBE), ультра жоғары вакуумдағы химиялық булардың тұндыру (UHV/CVD), атмосфералық және төмендетілген қысым эпитаксисі (ATM & RP Epi). Бұл мақалада негізгі материал ретінде кремнийі бар жартылай өткізгіш интегралды схема өндірісінде кеңінен қолданылатын кремний (Si) және кремний-германий (SiGe) эпитаксистік процестеріне назар аударылады.
1.2 SiGe Epitaxy артықшылықтары:
кезінде германий (Ge) белгілі бір үлесін қосуэпитаксиялық процессжолақ енін азайтып қана қоймай, транзистордың кесу жиілігін (fT) арттыратын SiGe монокристалды қабатын құрайды. Бұл оны сымсыз және оптикалық байланыстар үшін жоғары жиілікті құрылғыларда кеңінен қолдануға мүмкіндік береді. Сонымен қатар, жетілдірілген CMOS интегралды схема процестерінде Ge және Si арасындағы тордың сәйкессіздігі (шамамен 4%) тор кернеуін енгізеді, электрондардың немесе тесіктердің қозғалғыштығын арттырады және осылайша құрылғының қанықтыру тогы мен жауап беру жылдамдығын арттырады.
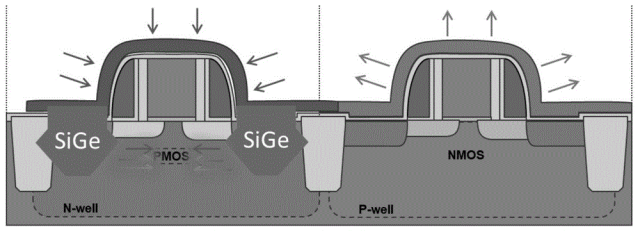
Кешенді SiGe эпитаксистік процесінің ағыны
2.1 Алдын ала емдеу:
Кремний пластиналары, ең алдымен, табиғи оксид қабатын және вафли бетіндегі қоспаларды кетіруді көздейтін қажетті процестің нәтижелеріне негізделген алдын ала өңделеді. Қатты легирленген субстрат пластиналары үшін келесі кезеңде автодопингті азайту үшін кері тығыздау қажет пе екенін ескеру өте маңызды.эпитаксияның өсуі.
2.2 Өсу газдары мен шарттары:
Кремний газдары: силан (SiH₄), дихлоросилан (DCS, SiH₂Cl₂) және трихлоросилан (TCS, SiHCl₃) ең жиі қолданылатын кремний газының үш көзі болып табылады. SiH₄ төмен температурадағы толық эпитаксистік процестерге жарамды, ал тез өсу жылдамдығымен танымал TCS қалың ерітінді дайындау үшін кеңінен қолданылады.кремний эпитаксисіқабаттар.
Германий газы: Germane (GeH₄) германийді қосудың негізгі көзі болып табылады, ол SiGe қорытпаларын қалыптастыру үшін кремний көздерімен бірге қолданылады.
Селективті эпитаксия: Селективті өсу салыстырмалы жылдамдығын реттеу арқылы қол жеткізіледіэпитаксиалды тұндыружәне хлоры бар кремний газы DCS пайдалана отырып, in situ ою. Селективтілік кремний бетіндегі Cl атомдарының адсорбциясы оксидтерге немесе нитридтерге қарағанда аз болғандықтан эпитаксиалды өсуді жеңілдетеді. Cl атомдары жоқ және активтену энергиясы төмен SiH₄ әдетте төмен температурадағы толық эпитаксистік процестерге ғана қолданылады. Тағы бір жиі қолданылатын кремний көзі, TCS, бу қысымы төмен және бөлме температурасында сұйық, оны реакция камерасына енгізу үшін H₂ көпіршіктерін қажет етеді. Дегенмен, ол салыстырмалы түрде арзан және оның жылдам өсу қарқыны үшін (5 мкм/мин дейін) кремний эпитаксистік пластиналар өндірісінде кеңінен қолданылатын қалың кремний эпитаксия қабаттарын өсіру үшін жиі қолданылады.
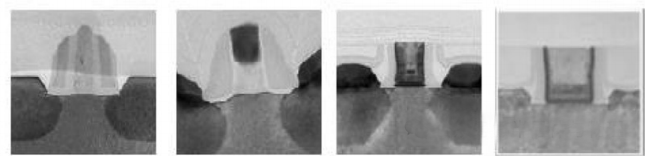
Эпитаксиалды қабаттардағы штамм кремний
кезіндеэпитаксистік өсу, эпитаксиалды монокристалды Si босаңсыған SiGe қабатында тұндырылған. Si және SiGe арасындағы тордың сәйкессіздігіне байланысты Si монокристалды қабаты NMOS транзисторларындағы электрондардың қозғалғыштығын айтарлықтай арттыра отырып, негізгі SiGe қабатынан созылу кернеуіне ұшырайды. Бұл технология қанықтыру тогын (Idsat) арттырып қана қоймай, құрылғының жауап беру жылдамдығын да жақсартады. PMOS құрылғылары үшін SiGe қабаттары саңылаулардың қозғалғыштығын арттырып, қанықтыру тогын арттыра отырып, арнаға қысу кернеуін енгізу үшін оюдан кейін бастапқы және ағызу аймақтарында эпитаксистік түрде өсіріледі.
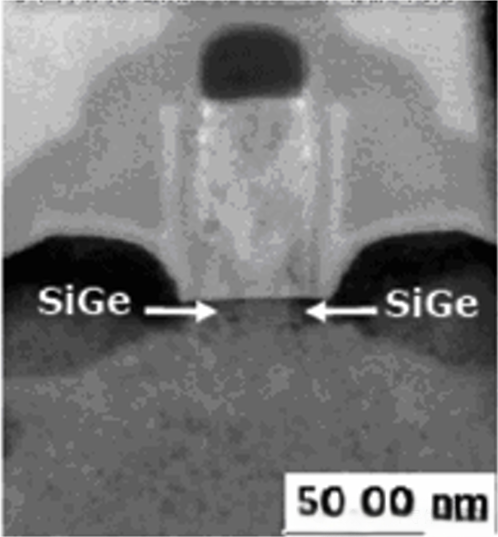
SiGe GAA құрылымдарындағы құрбандық қабаты ретінде
Gate-All-Around (GAA) нано сымды транзисторларды өндіруде SiGe қабаттары құрбандық қабаттары ретінде әрекет етеді. Квазиатомдық қабаттарды өңдеу (квази-ALE) сияқты жоғары селективті анизотропты ою әдістері нано сым немесе нанопарақ құрылымдарын қалыптастыру үшін SiGe қабаттарын дәл жоюға мүмкіндік береді.
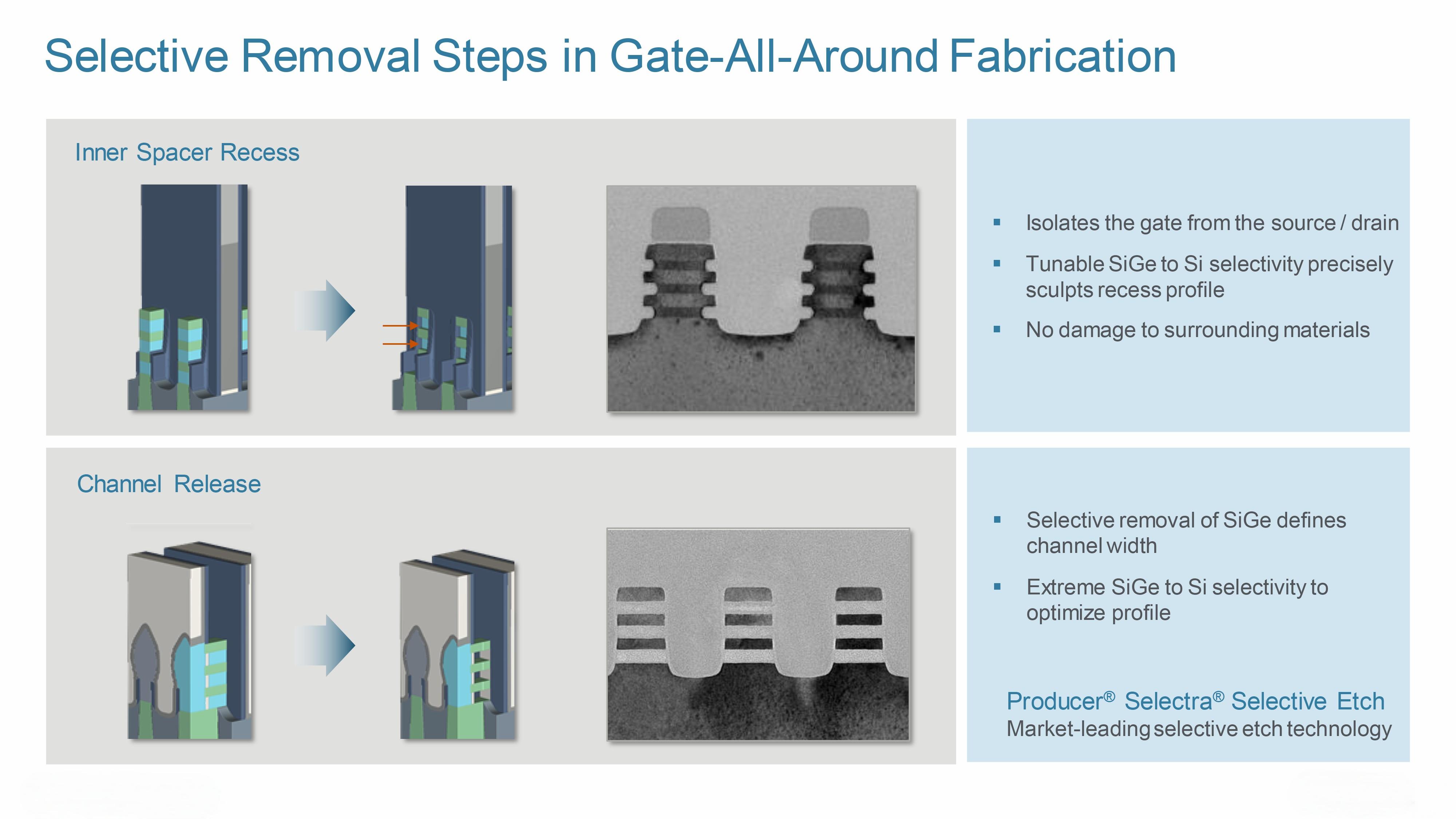
Semicorex-те біз маманданамызSiC/TaC қапталған графит ерітінділеріжартылай өткізгіштер өндірісінде Si эпитаксиалды өсуде қолданылады, егер сізде қандай да бір сұраулар болса немесе қосымша мәліметтер қажет болса, бізбен байланысудан тартынбаңыз.
Байланыс телефоны: +86-13567891907
Электрондық пошта: sales@semicorex.com




