
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Эпитаксиалды қабаттар: Жетілдірілген жартылай өткізгіш құрылғылардың негізі
1-сурет: допинг концентрациясы, қабат қалыңдығы және бірполярлы құрылғылар үшін бұзылу кернеуі арасындағы корреляцияны суреттейді.

SiC эпитаксиалды қабаттарын дайындау, ең алдымен, буланудың өсуі, сұйық фазалық эпитаксиясы (LPE), молекулалық сәуле эпитаксисі (MBE) және химиялық булардың тұндыру (CVD) сияқты әдістерді қамтиды, CVD зауыттарда жаппай өндірудің басым әдісі болып табылады.
1-кесте: Негізгі эпитаксиалды қабатты дайындау әдістеріне салыстырмалы шолу жасайды.

Жаңашыл тәсіл 2(b) суретінде көрсетілгендей, осьтен тыс субстраттардағы {0001} белгілі бір еңкейту бұрышында өсуді қамтиды. Бұл әдіс қадам өлшемін азайта отырып, қадамның тығыздығын айтарлықтай арттырады, бірінші кезекте қадамдық байлау орындарында нуклеацияны жеңілдетеді және осылайша эпитаксиалды қабаттың субстраттың қабаттасу ретін тамаша қайталауына мүмкіндік береді, политиптердің бірге болуын болдырмайды.
2-сурет: 4H-SiC-де сатылы басқарылатын эпитаксияның физикалық процесін көрсетеді.
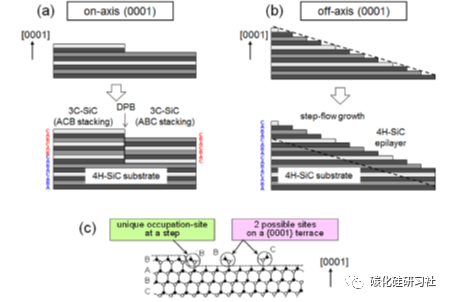
3-сурет: 4H-SiC үшін сатылы бақыланатын эпитаксиада CVD өсуінің маңызды шарттарын көрсетеді.

4-сурет: 4H-SiC эпитаксисі үшін әртүрлі кремний көздеріндегі өсу қарқынын салыстырады.

Төмен және орташа кернеуді қолдану саласында (мысалы, 1200В құрылғылар) SiC эпитаксистік технологиясы төмен және орташа вольтты SBD талаптарына сәйкес келетін қалыңдықта, қоспа концентрациясында және ақауларды бөлуде салыстырмалы түрде жоғары біркелкілікті ұсынатын жетілген кезеңге жетті. , MOS, JBS құрылғылары және т.б.
Дегенмен, жоғары вольтты домен әлі де айтарлықтай қиындықтарды тудырады. Мысалы, кернеуі 10000 В болатын құрылғыларға қалыңдығы шамамен 100 мкм болатын эпитаксиалды қабаттар қажет, бірақ бұл қабаттар төменгі вольтты аналогтарымен салыстырғанда айтарлықтай нашар қалыңдық пен қоспалау біркелкілігін көрсетеді, үшбұрышты ақаулардың құрылғының жалпы жұмысына зиянды әсерін айтпағанда. Биполярлық құрылғыларды ұнататын жоғары вольтты қолданбалар сонымен қатар азшылық тасымалдаушылардың қызмет ету мерзіміне қатаң талаптар қояды, бұл параметрді жақсарту үшін процесті оңтайландыруды қажет етеді.
Қазіргі уақытта нарықта 4 дюймдік және 6 дюймдік SiC эпитаксиалды пластиналар басым, үлкен диаметрлі SiC эпитаксиалды пластиналар үлесі біртіндеп артады. SiC эпитаксиалды пластинаның өлшемі негізінен SiC субстраттарының өлшемдерімен анықталады. Қазір коммерциялық қол жетімді 6 дюймдік SiC субстраттарымен 4 дюймден 6 дюймдік SiC эпитаксисіне өту тұрақты түрде жүріп жатыр.
SiC субстраттарын жасау технологиясы дамыған сайын және өндірістік қуаттар кеңейген сайын, SiC субстраттарының құны біртіндеп төмендейді. Субстраттардың эпитаксиалды пластиналар құнының 50% -дан астамын құрайтынын ескере отырып, субстрат бағасының төмендеуі SiC эпитаксиясы үшін шығындардың төмендеуіне әкеледі деп күтілуде, осылайша саланың жарқын болашағына уәде береді.**




